LightPFPを用いたSiO₂ドライエッチングシミュレーション
事例提供者:
株式会社Preferred Networks

テーマ概要
半導体製造プロセスにおいて、シリコン酸化膜(以降SiO2とします、 シリカ、シリコンダイオキサイドとも呼ばれます)のエッチングは微細加工の基盤技術として重要な技術です。近年、集積回路の高度化に伴い、より精密なパターニングを実現するためにドライエッチングが不可欠となり、活発に研究開発が進められています。ドライエッチングは、プラズマなどの活性種を利用することで高いアスペクト比と選択性を両立させ、反応生成物を気体として除去することでエッチング面を清浄に保ちます。特に、フッ化水素(HF)などの反応性が高いフッ素系ガスを用いたドライエッチングは、SiO2と反応して四フッ化ケイ素(SiF4)などの揮発性ガスを生成するため重要なドライエッチングプロセスとして研究されています[1]。しかしながら、ナノスケールでのエッチング過程を実験的に観察することは困難であり、原子レベルでの理解はまだ限られています。
本研究では、HFガスを用いたSiO2のドライエッチングを再現可能なLightPFPモデルを、アクティブラーニングを用いて作成しました。LightPFPの反応経路解析の結果はDFTレベルの精度を示しており、さらに、大規模なドライエッチングプロセスのシミュレーションでは、2nm のエッチング孔を形成する様子を再現しました。
本計算事例のサンプルスクリプトは、こちらのmatlantis-contrib 上で公開されています。

HFガスを用いたSiO2ドライエッチングの大規模分子動力学シミュレーション
計算モデルと計算方法
計算は以下の手順で実施しました。計算条件の詳細は別表に記載しています。
フェーズ1: LightPFP モデルの構築
LightPFPモデルは4段階で構築しました。
1)初期構造の作成:SiO₂結晶、SiO₂表面、エッチングガスであるHF、および、エッチングにより生成される様々なガス分子(例:SiF₄)の初期構造を作成しました。
2)初期データセットの生成: 分子動力学(MD)計算を用いてサンプリングを行いました。
3)アクティブラーニングによるデータ収集:アクティブラーニング技術を用いて、効率的に追加の訓練データを収集しました。このプロセスでは、スラブサイズとHF分子数を変化させることで、エッチング条件の複雑性を段階的に高めながら15回の反復を行いました。
4)LightPFP モデル訓練:最終的なLightPFPモデルは、初期データセット、アクティブラーニングによって収集したデータセット、そして、事前学習モデル「ALL_ELEMENTS_SMALL_NN_6」 を組み合わせて構築しました。
フェーズ2: 反応経路解析(LightPFPモデルの性能評価)
フェーズ2は、LightPFPモデルの性能を評価するために、NEB(Nudged Elastic Band)計算を実施しました。LightPFPから得られた結果は、PFPおよび先行研究[1]の結果と比較しました。NEB計算における始状態は、SiO₂クラスター(Si₄O₁₀H₄)とHFガス分子とし、終状態はSi表面の酸素にフッ素が吸着し、H₂O分子が脱離した状態として定義しました。
フェーズ3: 大規模ドライエッチングシミュレーション
フェーズ3では、LightPFPモデルを用いて、約72,000原子からなる大規模なSiO₂スラブモデル(10 nm×10 nm×10 nm)に対するHFガスによるドライエッチングのシミュレーションを実施しました。このシミュレーションでは、運動エネルギーが40eVのHFガス分子1,000個が、スラブ表面の2nm × 2nm の領域に焦点を合わせたビームとして照射されました。
計算結果と展望
SiO2クラスターに対するHFの反応経路解析
SiO2クラスターに対するHFの反応経路解析の結果、HF分子がSiO2表面に吸着し、Si-O結合を切断してSi-F結合を形成する様子が確認されました。LightPFPモデルはPFPと同等の精度を示し、反応障壁は定量的に一致しました。具体的には、PFPで順方向で1.029 eV、逆方向で1.561 eV であったのに対し、LightPFPでは順方向で 0.844 eV、逆方向で1.560 eVという結果が得られました。これらの結果は先行研究におけるReaxFFやDFTとも整合しています。
特に注目すべき点は、遷移状態構造は意図的に学習データに追加していないにも関わらず、LightPFPモデルがこれを正確に予測できたことです。これはアクティブラーニングによる訓練データの生成によりMDのトラジェクトリからこのような重要な構造を効率的に収集できたためと考えられます。このことからアクティブラーニング技術が高性能なLightPFPモデルの構築に有効であることが示されました。

Figure 2. SiO2クラスターに対するHFの反応経路
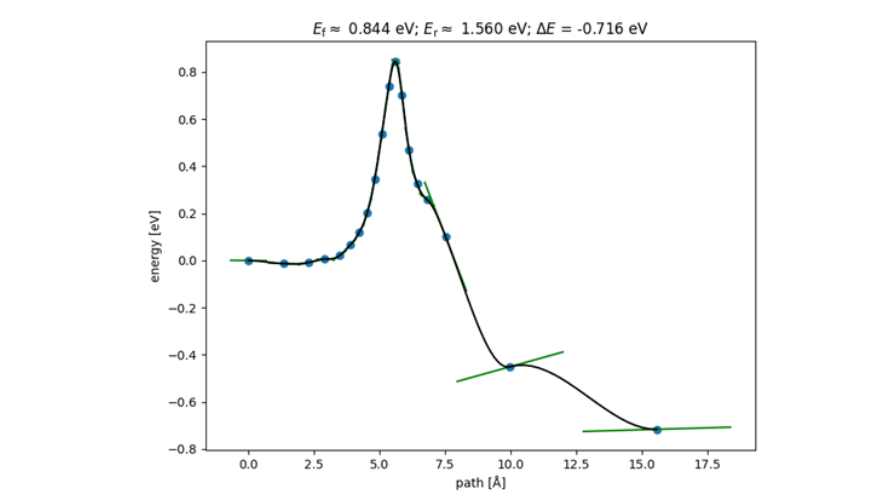
Figure 3. LightPFPによるSiO2クラスター上のHFの反応経路に対するエネルギープロファイル
エンタルピー変化ΔH [kcal/mol]および活性化エネルギーEa [kcal/mol]
| ΔH kcal/mol | Ea kcal/mol | |
|---|---|---|
| ReaxFF [1] | -19.78 | 42.64 |
| DFT [1] | -11.4 | 21.43 |
| PFP | -12.27 | 23.57 |
| LightPFP | -13.01 | 17.41 |
大規模ドライエッチングシミュレーション
大規模なSiO2スラブのエッチングシミュレーションでは、7万原子を超えるスラブ構造の表面の局所領域に1,000個のHF分子を衝突させることで、明確なエッチング孔の形成に成功しました。合計約500 psのMDシミュレーションでエッチング孔は表面から2nmを超える深さまで進行し、エッチング反応によってSi-F結合やSiF₄分子などの生成物が観測されました。従来のPFPやDFTではこのような規模および時間スケールのシミュレーションは困難でしたが、LightPFPモデルの優れた高速性により、約45時間という合理的な時間枠でシミュレーションを完了しました。
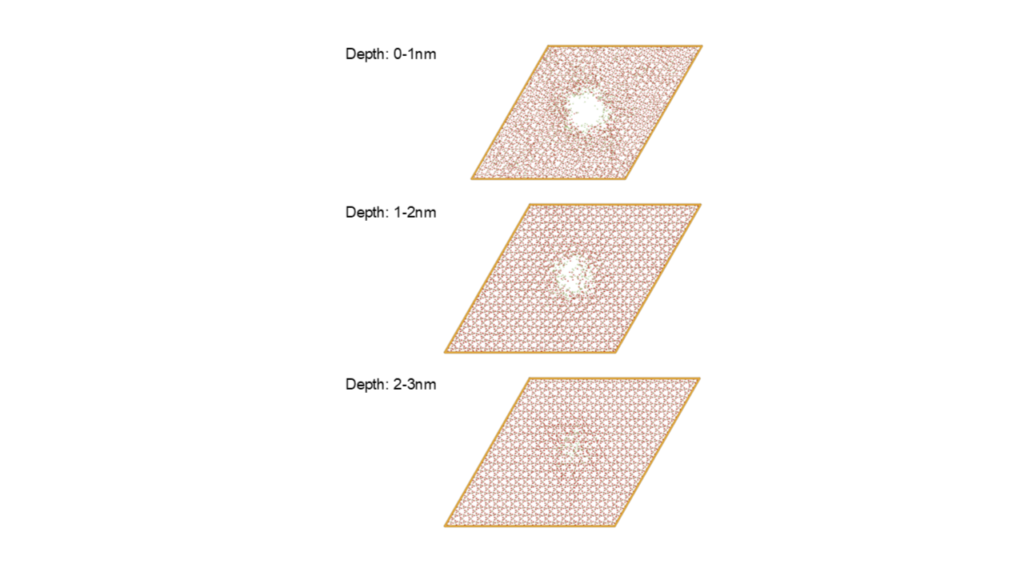
Figure 4. HFガス衝突後のSiO2スラブの構造変化

Figure 5. HFガス衝突によるSiO₂スラブのエッチング孔形成
将来展望
本研究で開発されたLightPFPモデルは半導体製造プロセスにおけるドライエッチング技術をさらに発展させる可能性を秘めています。具体的には、エッチングガス組成や入射エネルギーなどのプロセスパラメータ最適化、異なる表面構造や材料のエッチング特性予測、さらにはマスク材料との選択性向上などプロセス制御に有用な知見を提供することが期待されます。LightPFPを使用した大規模原子シミュレーションは、実験的に観察することが困難なナノスケールのプロセスを可視化し、プロセス開発に貴重な知見をもたらします。
計算条件
| 計算条件詳細 |
|---|
| 共通 | |
|---|---|
| PFPモデルバージョン | v7.0.0 |
| 計算モード | crystal_u0_plus_d3 |
| LightPFPモデル構築 (2):初期データセットの生成 | |
|---|---|
| サンプリング温度 [K] | 1000, 3000, 5000 |
| ステップ数 | 各温度で5,000ステップ |
| サンプリング間隔 | 100ステップ |
| LightPFPモデル構築 (3):アクティブラーニングによるデータ収集 | |
|---|---|
| 反復回数 | 15回 |
| スクリプト |
・運動エネルギー20–80eVのHF分子をSiO₂表面上に1つ挿入。 ・1000ステップのNVE MD、0.2fs/ステップ ・500ステップのNVT MD、1fs/ステップ ・複数のHF分子を注入するためにステップ1–3を繰り返す |
| 反復0–4 | 小さい (2,2,1) サイズの SiO₂ スラブ、10個の HF分子を挿入 |
| 反復5–9 | 小さい (2,2,1) サイズの SiO₂ スラブ、20個の HF分子を挿入 |
| 反復10–14 | 大きい (4,4,1) サイズの SiO₂ スラブ、40個の HF分子を挿入 |
| 反応経路解析 | |
|---|---|
| 手法 | NEB / CI-NEB法 |
| バネ定数 | k = 5.0 |
| 収束条件 | fmax = 0.07 |
| イメージ数 | 19 |
| 大規模ドライエッチングシミュレーション | |
|---|---|
| システムサイズ | 約72,000原子(SiO₂ スラブ) |
| HF分子数 | 1,000 個 |
| 入射エネルギー [eV] | 40 |
| MD計算 |
1.初期構造緩和:NVT 5ps 2.HF1分子入射:NVE 200ps(0.5fs/step) 3.緩和:NVT 300ps(1fs/step) ※ 上記2・3を1,000回繰り返し(合計500ps) |
| シミュレーション時間 | 合計で約45時間 |